分光干渉式ウェーハ厚み計 SF-3
|
|
ウェーハ等の研削研磨プロセスにおいて、非接触でウェーハや樹脂の厚みを超高速・高精度に測定を行います。 |
|
|
|
- 製品情報
- 仕 様
- 装置構成
- マッピング
- 測定例
製品情報
動 画 測定から結果まで
特 長
- 光学式により非接触・非破壊での厚み測定が可能
- 高い測定再現性を実現
- 高速でリアルタイムに研磨モニタが可能
- 長いWD(ワークディスタンス)を実現し、機器への組み込みが容易
- ホスト機器からLANを使用したTCP/IP通信で制御
- 多層厚み測定が可能
- テンポラリーウェーハ(仮貼り合わせウェーハ)の各層厚み測定が可能


測定項目
- 厚み測定(5層)
用途
- 各種ウェーハ(Silicon、その他化合物ウェーハ)厚み測定
- 各種 研削・研磨・貼り合わせなどへのプロセスへの組み込み
- ウェーハ以外の厚膜部材厚み測定
半導体プロセスへの組み込み例
■ テンポラリーボンディング
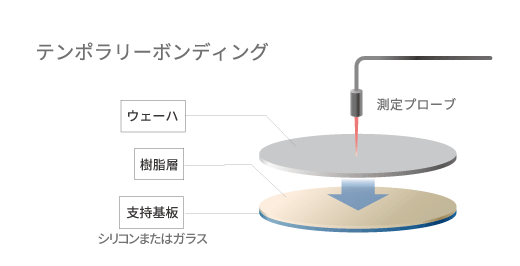

■ バックグラインド
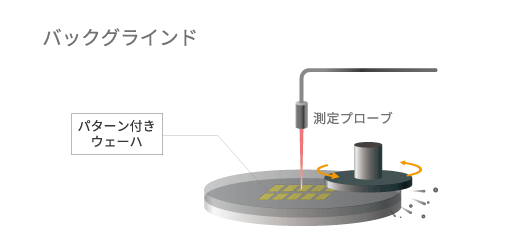

■ ウェットエッチング

■ CMPプロセス
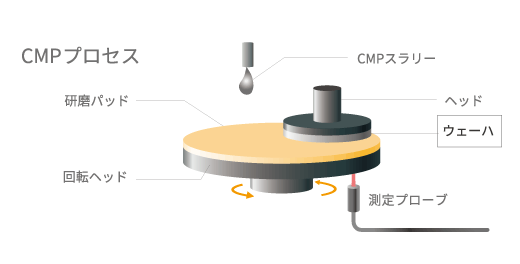
仕 様

*1 : 当初基準サンプルAirGap約1000 μm測定時の相対標準偏差(n = 20)
*2 : WD80 mmプローブ仕様時の設計値
装置構成

マッピング
■300 mmウェーハ対応マッピングシステム
- 微細パターンをアライメントし、ウェーハ厚みや各種厚み情報を提供
- 高精度X-Y位置決めステージ(±2μm以下)を実装し、高精度な位置決めを実現
- ウェーハ形状以外にも対応可能
- 測定ポイント周辺の視野を確認可能
- 半導体向け300mmウェーハ対応
- MEMSやセンサーデバイス対応
測定例
測定例
 |
|
Φ300 mm siliconウェーハ厚み測定 |
- 製品情報
- 仕 様
- 装置構成
- マッピング
- 測定例
関連情報
関連製品
|
|
ロードポート対応膜厚測定システム GS-300 |
|
|
組込み型膜厚モニター |
|
|
膜厚モニター FE-300F |
|
|
超高速分光干渉式厚み計 |
|
|
顕微分光膜厚計 OPTM series |
|
|
分光エリプソメータ FE-5000 series |
|
|
マルチチャンネル分光器 MCPD-9800/6800 |


 Close
Close

















