分光エリプソメータ FE-5000 series
|
|
高精度な薄膜解析が可能な分光エリプソメトリーに加え、測定角度の自動可変機構を実装させることにより、あらゆる種類の薄膜にも対応しております。従来の回転検光子法に加え、位相差板の自動脱着機構を設けることにより、測定精度を向上させました。
※資料やカタログダウンロードには会員登録が必要です |
|
|
|
- 製品情報
- 原 理
- 仕 様
- 測定例
製品情報
- 紫外可視(300~800nm)の波長領域でのエリプソパラメータ測定が可能
- ナノメータオーダーの多層薄膜の膜厚解析が可能
- 400ch以上のマルチチャンネル分光法によるエリプソスペクトルの迅速測定が可能
- 反射角度可変測定により、薄膜の詳細な解析に対応
- 光学定数のデータベース化およびレシピ登録機能の追加により操作性がアップ
- エリプソパラメータ(tanψ、cosΔ)測定
- 光学定数 ( n : 屈折率 , k : 消衰係数 ) 解析
- 膜厚解析
- 半導体ウェーハ
ゲート酸化薄膜,窒化膜
SiO2,SixOy,SiN,SiON,SiNx,Al2O3,SiNxOy,poly-Si,ZnSe, BPSG,TiN
レジストの光学定数(波長分散) - 化合物半導体
AlxGa(1-x)As 多層膜,アモルファスシリコン - FPD
配向膜 - 各種新素材
DLC(Diamond Like Carbon),超伝導用薄膜,磁気ヘッド薄膜 - 光学薄膜
TiO2,SiO2,反射防止膜 - リソグラフィー分野
g線(436nm),h線(405nm),i線(365nm)などの各波長におけるn,k評価
原 理
試料にs波とp波を含む直線偏光を入射し、その反射光の楕円偏光を測定します。s波とp波は位相と振幅が独立に変化して、試料に依存した2種類の偏光の変換パラメータであるp波とs波の反射率の比tanψおよび位相差Δが得られます。
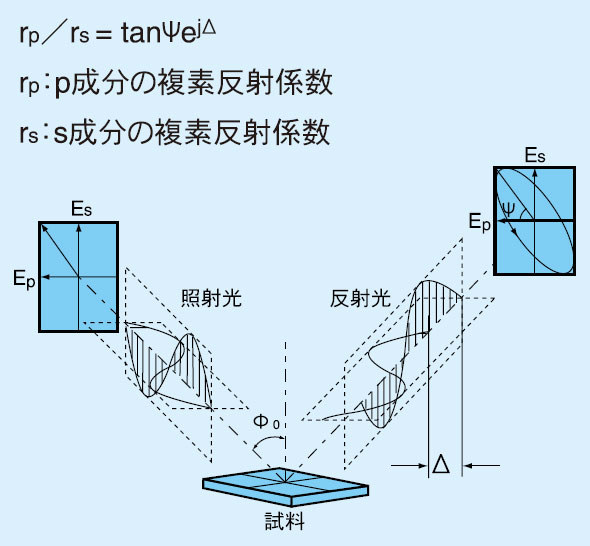
tanψ、consΔはエリプソパラメータと呼ばれており、分光エリプソメトリーではこの2つのパラメータの波長依存スペクトルが測定されます。
仕 様
| 型式 | FE-5000 series | |
| 測定方式 | 回転検光子法*1 | |
| 測定膜厚範囲(nd) | 0.1nm~1μm | |
| 入射(反射)角度範囲 | 45~90° | |
| 入射(反射)角度駆動方式 | 自動サインバー駆動方式 | |
| tanψ測定正確さ | ±0.01以下 | |
| cosΔ測定正確さ | ±0.01以下 | |
| 膜厚の繰り返し再現性 | 0.01%以下*2 | |
| 波長範囲*3 | 300~800nm | |
| 測定用光源 | 高安定キセノンランプ | |
| ステージ駆動方式 | 手動/自動 | |
*1 偏光子駆動可能、不感帯に有効な位相差板着脱可能です。
*2 VLSIスタンダードSiO2膜(100nm)を用いた場合の値です。
*3 自動ステージ選択時の値です。
測定例
液晶ディスプレイなどに用いられる透明電極材料であるITO(Indium-tin-oxide)は、製膜後のアニール処理(熱処理)によって導電性や色味が向上します。その際、酸素状態や結晶性も変化しますが、この変化は膜の厚みに対して段階的に傾斜変化することがあり、光学的に組成が均一な単層膜として見なすことができません。
このようなITOに対し、傾斜モデルを用いて、上部界面と下部界面のnkから、傾斜の度合いを測定した事例を紹介します。
サンプルの表面に粗さ(Roughness)がある場合、表面粗さを雰囲気(Air)と膜厚材料が比率 1 対 1 で混合した“粗さ層”としてモデル化し、粗さと膜厚を解析することが可能です。 ここでは表面粗さが数nmあるSiN(窒化シリコン)を測定した事例を記載します。
有機EL材料は酸素や水分に弱く、通常大気下では変質・ダメージを受けてしまう場合があります。そこで、製膜後はすぐにガラスで封止をされます。 封止された状態のまま、ガラス越しに膜厚を測定した事例を記載します。 ガラスと中間の空気層は、非干渉層モデルを用います。
最小二乗法でフィッティングをして膜厚値(d)を解析するには材料のnkが必要です。nkが未知の場合、d とnkの両方を可変パラメータとして解析します。 しかしながら、d が100nm以下の極薄膜の場合、d とnkとを分離することができず、そのため精度が低下して正確な d が求められないことがあります。 このような場合、d の異なるサンプルを複数測定し、nkが同一であると仮定して同時解析(複数点解析)をします。これにより精度よくnkを求め、正確な d を求めることが可能です。
- 製品情報
- 原 理
- 仕 様
- 測定例
関連情報
関連製品
|
|
膜厚モニター FE-300F |
|
|
組込み型膜厚モニター |
|
|
マルチチャンネル分光器 MCPD-9800/6800 |
|
|
分光干渉式ウェーハ厚み計 SF-3 |


 Close
Close
![傾斜モデルを用いたITOの構造解析 [FE-0006]](https://www.otsukael.jp/upload/files/FE-5000%E6%B8%AC%E5%AE%9A%E4%BE%8B0006.gif)
![傾斜モデルを用いたITOの構造解析 [FE-0006]](https://www.otsukael.jp/upload/files/FE5_m_02.jpg)
![表面粗さを考慮した膜厚値測定 [FE-0008]](https://www.otsukael.jp/upload/files/FE-5000%E6%B8%AC%E5%AE%9A%E4%BE%8B0008.gif)
![表面粗さを考慮した膜厚値測定 [FE-0008]](https://www.otsukael.jp/upload/files/APP8-2.jpg)
![非干渉層モデルを用いた封止済み有機EL材料の測定 [FE-0011]](https://www.otsukael.jp/upload/files/FE-5000%E6%B8%AC%E5%AE%9A%E4%BE%8B0011.gif)
![非干渉層モデルを用いた封止済み有機EL材料の測定 [FE-0011]](https://www.otsukael.jp/upload/files/APP11-2.jpg)
![複数点同一解析を用いたnk未知の極薄膜の測定 [FE-0014]](https://www.otsukael.jp/upload/files/FE-5000%E6%B8%AC%E5%AE%9A%E4%BE%8B0014.gif)
![複数点同一解析を用いたnk未知の極薄膜の測定 [FE-0014]](https://www.otsukael.jp/upload/files/APP14-2.jpg)













