ロードポート対応膜厚測定システム GS-300
|
|
パターンマッチ機能搭載、X-Y位置決め精度2um以下のシステムです。 |
|
|
|
- 製品情報
- 仕様
- 測定例
製品情報
特 長
- Φ300mmEFEMユニット予備ポートへのインテグレーションに対応
- ウェーハに埋め込んだ配線パターンのパターンアライメントを実現
- 半導体プロセスの高スループット要求に対応
- ノッチアライメント機能に対応
- 小フットプリント仕様
測定事例
- TSV埋め込みパターンウェーハの研削後Silicon厚み
- Φ300mmサイズのウェーハ厚み
動 画
仕様
仕様
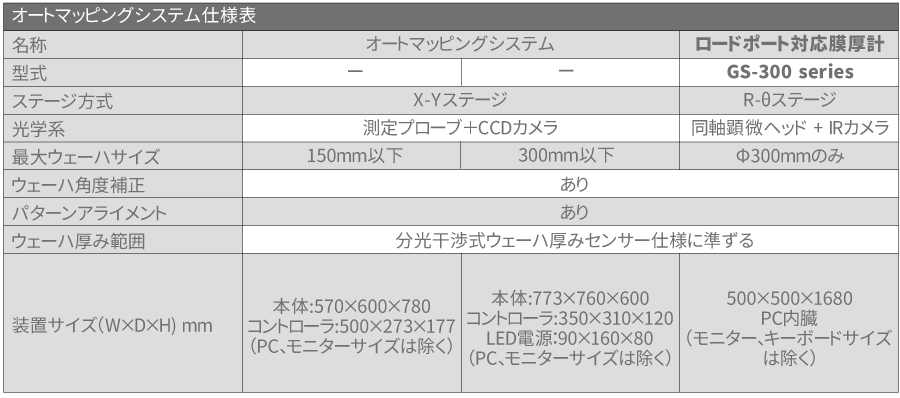
測定例
測定例
■研削後300mmウェーハ
 |
|
Si層厚み分布(約771μm) |
- 製品情報
- 仕様
- 測定例
関連情報
関連製品
|
|
分光干渉式ウェーハ厚み計 SF-3 |
|
|
超高速分光干渉式厚み計 |
|
|
組込み型膜厚モニター |
|
|
顕微分光膜厚計 OPTM series |
|
|
膜厚モニター FE-300F |
|
|
分光エリプソメータ FE-5000 series |
|
|
マルチチャンネル分光器 MCPD-9800/6800 |


 Close
Close
















