膜厚モニター FE-300F
|
|
高精度な光干渉法による膜厚測定を簡単操作で実現した小型で低価格な膜厚計です。
※資料やカタログダウンロードには会員登録が必要です |
|
|
|
|
|
- 製品情報
- 原理
- 仕様
製品情報
- 小型・低価格・簡単操作で膜厚測定
- 分光器、光源の選択により測定膜厚範囲の選択可能
- 条件設定や測定操作が簡単。どなたでも手軽に測定可能
- リアルタイムモニター機能やシュミレーション機能などを搭載
- 測定スポット径φ1.2mmで、3nm~35μmの薄膜から厚膜まで
幅広い測定に対応
- 絶対反射率測定
- 膜厚解析(10層)
- 光学定数解析(n:屈折率、k:消衰計数)
- 機能性フィルム、プラスチック
透明導電膜(ITO、銀ナノワイヤー)、位相差フィルム、偏光フィルム、ARフィルム、PET、PEN、TAC、PP、PC、PE、PVA、接着剤、粘着剤、プロテクトフィルム、ハードコート、耐指紋剤など - 半導体
化合物半導体、Si、酸化膜、窒化膜、Resist、SiC、GaAs、GaN、InP、InGaAs、 SOI、Sapphire、など - 表面処理
DLCコート、防錆剤、防曇剤、など - 光学材料
フィルタ、ARコート、など - FPD
LCD(CF、ITO、LC、PI)、OLED(有機膜、封止剤)、など - その他
HDD、磁気テープ、建材、など
原理
大塚電子では、光干渉法と自社製高精度分光光度計により、非接触・非破壊かつ高速高精度な膜厚測定を可能にしています。光干渉法は、図2のような分光光度計を利用した光学系によって得られた反射率を用いて光学的膜厚を求める方法です。図1のように金属基板上にコーティングされた膜を例にとると、対象サンプル上方から入射した光は膜の表面で反射します(R1)。さらに膜を透過した光が基板(金属)や膜界面で反射します(R2)。このときの光路差による位相のずれによって起こる光干渉現象を測定し、得られた反射スペクトルと屈折率から膜厚を演算する方法を光干渉法と呼びます。解析手法は、ピークバレイ法、周波数解析法、非線形最小二乗法、最適化法の4種類があります。
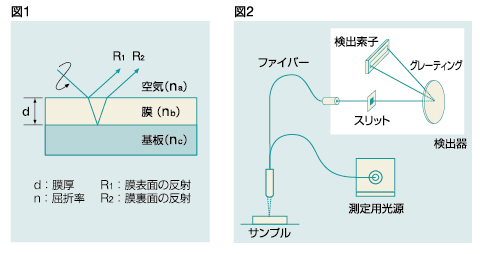
仕様
| 測定波長範囲 | 300~800nm | |
| 測定膜厚範囲 (SiO2換算) |
3nm~35μm | |
| スポット径 | φ1.2mm | |
| サンプルサイズ | φ200×5(H)mm | |
| 測定時間 | 0.1~10s以内 | |
| 電源 | AC100V±10% 300VA | |
| 寸法、重量 | 280(W)×570(D)×350(H)mm、24kg | |

- 製品情報
- 原理
- 仕様
関連情報
関連製品
|
|
顕微分光膜厚計 OPTM series |
|
|
スマート膜厚計 SM-100 series |
|
|
組込み型膜厚モニター |
|
|
マルチチャンネル分光器 MCPD-9800/6800 |
|
|
分光エリプソメータ FE-5000 series |
|
|
分光干渉式ウェーハ厚み計 SF-3 |


 Close
Close















