顕微分光膜厚計 OPTM series
|
|
OPTM(オプティム)は、顕微分光を用いた微小領域での絶対反射率測定により、高精度な膜厚・光学定数解析が可能な装置です。 |
|
|
|
|
|
- 製品情報
- 仕様
- 測定項目
- 測定例
製品情報
- 膜厚測定に必要な機能をヘッド部に集約
- 顕微分光で高精度な絶対反射率測定(多層膜厚、光学定数)
- 1ポイント1秒以内の高速測定
- 顕微下で広い測定波長範囲を実現する光学系(紫外~近赤外)
- エリアセンサーによる安全機構
- 初めての方でも光学定数解析が可能な楽々解析ウイザード
- 測定シーケンスをカスタマイズ可能なマクロ機能搭載
- 複雑な光学定数も解析可能(複数点解析法)
- 300mmステージ対応可能
- 各種カスタマイズに対応

試料の形状・部位に応じて容易に測定シーケンスをカスタマイズ可能
仕様
| タイプ | OPTM-A1 | OPTM-A2 | OPTM-A3 |
| 波長範囲 | 230~800 nm | 360~1100 nm | 900~1600 nm |
| 膜厚範囲*1 | 1 nm~35 μm | 7 nm~49 μm | 16 nm~92 μm |
| サンプルサイズ*2 | 最大200×200×17 mm | ||
| スポット径 | φ5、φ10、φ20、φ40 µm | ||
※上記は自動XYステージ付きの仕様となります。
*1 膜厚範囲はSiO2換算となります。
*2 300 mmステージについては別途お問合せ下さい。
| タイプ | 自動XYステージタイプ | 固定フレームタイプ | 組込みヘッドタイプ |
| 寸法 (W×D×H) |
556×566×618 mm | 368×468×491 mm | 210×441×474 mm 90×250×190 mm* |
| 重量 | 66 kg | 38 kg | 23 kg 4 kg* |
| 最大消費電力 | AC100V±10V 500VA | AC100V±10V 400VA | |
*AC/DC電源ユニット

自動XYステージタイプ

組込みヘッドタイプ
測定項目
- 絶対反射率測定
- 膜厚解析
- 光学定数解析(n:屈折率、k:消衰係数)
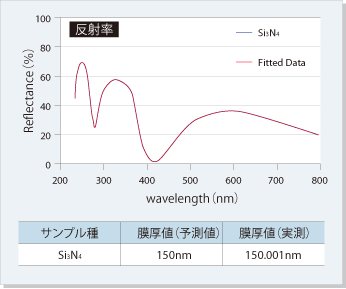
測定例
半導体トランジスタは電流の通電状態を制御することで信号を伝達していますが、電流が漏れたり別のトランジスタの電流が勝手な通路を通り回り込むことを防止するために、トランジスタ間を絶縁するための絶縁膜が埋め込まれています。絶縁膜にはSiO2(二酸化シリコン)やSiN(窒化シリコン)が用いられます。SiO2は絶縁膜として、SiNはSiO2より誘電率の高い絶縁膜として、または不必要なSiO2をCMPで除去する際のストッパーとして使用され、その後にSiNも除去されます。このように絶縁膜としての性能、正確なプロセス管理のため、これらの膜厚を測定する必要があります。
液晶ディスプレイは一般に 右図のような構造です。CFは一画素にRGBがあり、非常に高精細の微小パターンである。CFの製膜方法は顔料をベースとしたカラーレジストをガラス全面に塗布しフォトリソグラフィによって露光、現像しパターンニング部分のみを残す工程をRGBごとに行うのが主流です。この際にカラーレジストの厚みが一定でないとパターンの変形、カラーフィルターとしての色味の変化の原因になるため、膜厚値を管理することは重要です。
近年、様々な機能を持つ高機能フィルムを用いた製品が一般に普及しており、用途によってはフィルム表面に耐摩擦、耐衝撃、耐熱、耐薬品などの性能を持つ保護フィルムが必要になることもあります。保護フィルム層としてハードコート(HC)膜を製膜することが一般的ですが、HC膜の厚みによって保護フィルムとして機能しなかったり、フィルムにそりが生まれたり、見た目のムラや歪みの原因になるため、HC層の膜厚値を管理する必要があります。
液晶ディスプレイなどに用いられる透明電極材料であるITO(Indium-tin-oxide)は、製膜後のアニール処理(熱処理)によって導電性や色味が向上します。その際、酸素状態や結晶性も変化しますが、この変化は膜の厚みに対して段階的に傾斜変化することがあり、光学的に組成が均一な単層膜として見なすことができません。 このようなITOに対し、傾斜モデルを用いて、上部界面と下部界面のnkから、傾斜の度合いを測定した事例を紹介します。
サンプルの表面に粗さ(Roughness)がある場合、表面粗さを雰囲気(Air)と膜厚材料が比率 1 対 1 で混合した“粗さ層”としてモデル化し、粗さと膜厚を解析することが可能です。 ここでは表面粗さが数nmあるSiN(窒化シリコン)を測定した事例を記載します。
有機EL材料は酸素や水分に弱く、通常大気下では変質・ダメージを受けてしまう場合があります。そこで、製膜後はすぐにガラスで封止をされます。 封止された状態のまま、ガラス越しに膜厚を測定した事例を記載します。 ガラスと中間の空気層は、非干渉層モデルを用います。
最小二乗法でフィッティングをして膜厚値(d)を解析するには材料のnkが必要です。nkが未知の場合、d とnkの両方を可変パラメータとして解析します。 しかしながら、d が100nm以下の極薄膜の場合、d とnkとを分離することができず、そのため精度が低下して正確な d が求められないことがあります。 このような場合、d の異なるサンプルを複数測定し、nkが同一であると仮定して同時解析(複数点同一解析)をします。これにより精度よくnkを求め、正確な d を求めることが可能です。
基板表面が鏡面でないラフネスの大きなサンプルの場合、散乱により測定光が低下し、測定された反射率が実際より低くなります。界面係数を用いて基板表面での反射率の低下を考慮することで、あれた基板上の薄膜の膜厚値を測定することが可能です。例として、ヘアライン仕上げされたアルミ基板上の樹脂膜の膜厚測定の事例を記載します。
DLC(diamond‐like carbon)はアモルファス(非晶質)な炭素系材料です。高硬度・低摩擦係数・耐摩耗性・電気絶縁性・高バリア性・表面改質や他材料との親和性向上等の特徴があり、さまざまな用途に利用されています。近年、各用途に応じた膜厚測定の要求が高まっています。
DLCの厚み測定はモニター・サンプルを用意してその断面を電子顕微鏡にて観察する破壊検査が一般的でしたが、大塚電子の採用する光干渉式膜厚計であれば非破壊かつ高速に測定が可能です。測定波長範囲を変えることで極薄膜から超厚膜まで幅広い膜厚が測定できます。
独自の顕微鏡光学系を採用することでモニター・サンプルではなく、形状のあるサンプルの実測定が可能になりました。また、測定箇所をモニターで確認しながら測定を行うことで異常原因の分析に役立てることができます。
特注でさまざまな形状に対応した傾斜・回転ステージをご用意いたします。実サンプルの任意の複数箇所が測定可能です。
光干渉式膜厚系の弱点である材料の光学定数(nk)が分からないと正確な膜厚測定ができない問題は、独自の解析手法:複数点解析を用いて、予めご用意いただいた厚みの異なる複数サンプルを同時解析することで従来に比べ非常に高精度にnkを求めることが可能です。
NIST(National Institute of Standards and Technology)検定の標準サンプルで校正を行うことでトレーサビリティを保証します。
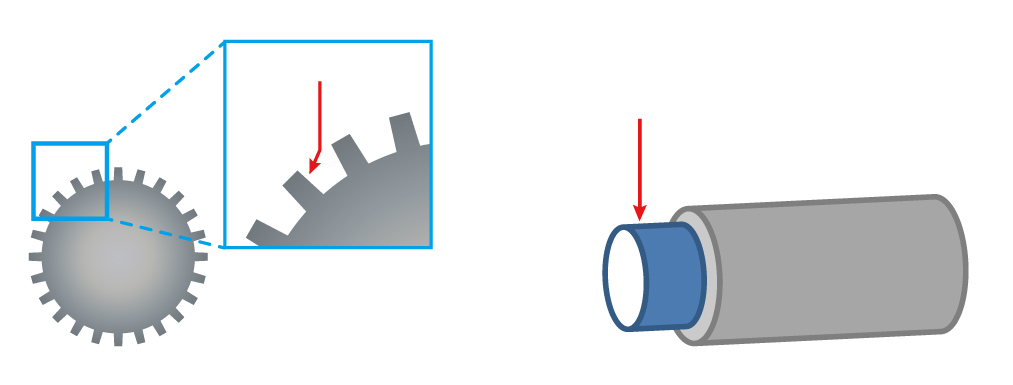
○ギア ○シャフト
- 製品情報
- 仕様
- 測定項目
- 測定例
関連情報
関連製品
|
|
膜厚モニター FE-300F |
|
|
スマート膜厚計 SM-100 series |
|
|
組込み型膜厚モニター |
|
|
マルチチャンネル分光器 MCPD-9800/6800 |
|
|
分光エリプソメータ FE-5000 series |
|
|
分光干渉式ウェーハ厚み計 SF-3 |


 Close
Close
![SiO2 SiNの膜厚測定 [FE-0002]](https://www.otsukael.jp/upload/files/OPTM_app_01.jpg)
![SiO2 SiNの膜厚測定 [FE-0002]](https://www.otsukael.jp/upload/files/FE-300_app_02.jpg)
![SiO2 SiNの膜厚測定 [FE-0002]](https://www.otsukael.jp/upload/files/FE-300_app_03.jpg)
![カラーレジスト(RGB)の膜厚測定 [FE-0003]](https://www.otsukael.jp/upload/files/OPTM_app_02.jpg)
![カラーレジスト(RGB)の膜厚測定 [FE-0003]](https://www.otsukael.jp/upload/files/APP3-2.jpg)
![ハードコートの膜厚測定 [FE-0004]](https://www.otsukael.jp/upload/files/OPTM_app_03.jpg)
![ハードコートの膜厚測定 [FE-0004]](https://www.otsukael.jp/upload/files/APP4-2.jpg)
![傾斜モデルを用いたITOの構造解析 [FE-0005]](https://www.otsukael.jp/upload/files/OPTM_app_04.jpg)
![傾斜モデルを用いたITOの構造解析 [FE-0005]](https://www.otsukael.jp/upload/files/APP5-2.jpg)
![表面粗さを考慮した膜厚値測定 [FE-0007]](https://www.otsukael.jp/upload/files/OPTM_app_05.jpg)
![表面粗さを考慮した膜厚値測定 [FE-0007]](https://www.otsukael.jp/upload/files/APP7-2.jpg)
![非干渉層モデルを用いた封止済み有機EL材料の測定 [FE-0010]](https://www.otsukael.jp/upload/files/OPTM_app_07.jpg)
![非干渉層モデルを用いた封止済み有機EL材料の測定 [FE-0010]](https://www.otsukael.jp/upload/files/APP10-2%281%29.jpg)
![複数点同一解析を用いた nk 未知の極薄膜の測定 [FE-0013]](https://www.otsukael.jp/upload/files/OPTM_app_08.jpg)
![複数点同一解析を用いた nk 未知の極薄膜の測定 [FE-0013]](https://www.otsukael.jp/upload/files/APP13-2.jpg)
![界面係数を用いたあれた基板上の膜厚測定 [FE-0015]](https://www.otsukael.jp/upload/files/OPTM_app_09.jpg)
![界面係数を用いたあれた基板上の膜厚測定 [FE-0015]](https://www.otsukael.jp/upload/files/APP15-2.jpg)
![さまざまな用途のDLCコーティング厚みの測定]](https://www.otsukael.jp/upload/files/DLC-0%282%29.jpg)