【入門】分光法による膜厚解析
4.複素屈折率の解析
薄膜の光吸収係数は、消衰係数kとして取り扱われます。化学分析で用いられている吸光度との違いは、波長を掛け合わせることにより、屈折率と同様に無次元化しています。また、複素屈折率Nは、電磁波の理論的関係式で屈折率nと消衰係数kを用いて、下式の通り単純化された数式に表現されます。なお、光は真空中に比べ、屈折率nの媒体中では遅く進み、消衰係数が大きくなると強度が減衰します。
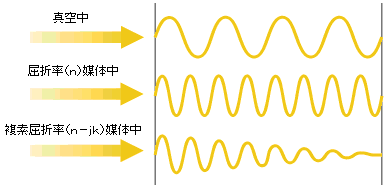
N=n-jk
単純に膜厚だけを測定する場合、消衰係数はパラメータを増やし、解析を難しくするだけのため、一般的には測定光源に近赤外光を用いて、吸収のない波長で測定することが多くなります。液晶用カラーフィルターでは、着色は品質上における重要なファクターであるため、特に干渉による着色が加わり、表示デバイスの色調を変化させてしまうことさえあります。また、半導体分野では、結晶内部の電子状態の準位を示す重要な指標であるため、kの測定がますます重要になってきます。
さらに、絶縁膜では着色により、デバイス性能に問題が生じるため、kを低く押さえるように成膜条件を整えます。
消衰係数kは、スペクトル形状が既知の場合には、反射分光スペクトルから正確に求めることができ、屈折率と消衰係数との間で成立するクラマース-クロニッヒの関係を利用し、パラメータを減らすことが可能です。しかし、スペクトル形状が変化する場合には、測定精度はあまり期待できません。なお、スペクトルパターンが不明の場合には、反射分光スペクトルからkを求めることはできません。
薄膜の消衰係数を高精度で測定するためには、測定した透過スペクトルを分光エリプソ・スペクトルや、反射スペクトルと組み合わせる必要があります。この手法はかなり一般的なのですが、基板が透明な場合に限られるという欠点があります。
シリコン基板の屈折率はよく調べられており、文献も多く存在するのですが、それにもかかわらず、この文献に掲載されている数値は、お互いに異なっています。通常の成膜はSi基板上で行われるため、屈折率と消衰係数の両者が異なっていても、結果として得られる反射スペクトルや、分光エリプソ・スペクトルは、完全に理論計算と一致しています。近年では、エピタキシャル成長させたSi膜を絶縁基板上に貼り付けて、それを半導体基板に用いるようになってきており、このようなSi膜では光が透過するため、消衰係数の違いがスペクトルに直接反映します。つまり文献値を用いても測定スペクトルを精度良く解析できず、文献値との間にズレが出てきます。つまり文献値が相当の誤差を持っている例です。
関連製品
| 顕微分光膜厚計 OPTM series | |
| 膜厚モニター FE-300F | |
| 組込み型膜厚モニター | |
| 分光エリプソメータ FE-5000 series |


 Close
Close





