ラインスキャン膜厚計によるインライン膜厚計測
3.膜厚測定の原理
当社では、プッシュブルーム(ラインスキャン)方式のハイパースペクトルカメラを開発、販売しています。ラインスキャン膜厚計は、ハイパースペクトルカメラによって測定された分光スペクトルから膜厚を求めます。(第2図)
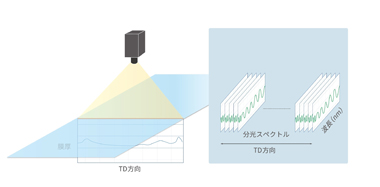
第2図 ラインスキャン膜厚計の測定
当社の膜厚演算は、分光干渉法を採用しています。分光干渉法とは、膜(フィルム)表面で反射した光と膜を透過し裏面で反射した光が、膜の厚み分の光路差で生じる位相のずれによって干渉する現象を測定し、その分光スペクトルの周期性や形状から膜厚を得る手法です。
第3図に干渉が発生する概念図を示します。ある波長では、表面で反射した光と膜を透過した光の位相が揃うことで反射強度が強くなり、別の波長で、それぞれの位相が逆位相になることで反射強度が弱くなります。これらの反射強度を波長ごとにプロットすると、膜厚に応じた分光干渉スペクトルが得られます。
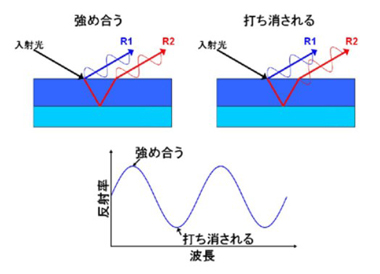
第3図 光干渉の発生現象

第4図 振幅反射率式
上記の現象を振幅反射率の式で示したものが第4図です。この式から、位相因子βと振幅反射率rは波長λの関数であることがわかります。これはrが波長λに対して周期性を持つことを意味しています。βには屈折率N、膜厚d、屈折角θの変数が含まれています。つまり、同一材料でも膜厚dによって干渉の周期が変化することを示しています。このことから、分光干渉スペクトルを周波数解析することで膜厚を求めることができることがわかります。
関連製品
| ラインスキャン膜厚計®【インラインタイプ】 | |
| ラインスキャン膜厚計®【オフラインタイプ】 |


 Close
Close



