
無事終了いたしました。
多数のご来場を頂き、誠にありがとうございました
多数のご来場を頂き、誠にありがとうございました
米国サンフランシスコで開催される半導体製造装置や部材の国際展示会「SEMICON West 2014」に出展します。分光干渉式と独自の解析アルゴリズムを採用することにより、半導体ウエハーを薄化するバックグラインド工程(BG)やウエハー表面の微細な凹凸を平滑にする化学機械研磨プロセス(CMP)および貼り合わせウエハーの各厚みの測定において、高速かつリアルタイムに計測できるウエハー厚モニタリング装置を展示します。ぜひ弊社ブースへお立ち寄りください。
| ●名 称 | SEMICON West 2014 |
| ●会 期 | 2014年7月8日(火)~ 7月10日(木) |
| ●会 場 | モスコーニ・センター(サンフランシスコ,米国) |
| φ450mmウェハー、厚み1.8mmに対応 | ||
● 450mmウェハー厚検査装置 SF-450M 分光干渉法により非接触・非破壊で高い測定再現性を実現しています。
多層の厚み測定が可能です。
|
| ウェハー裏面測定により、Si厚さ・TSV深さの測定が可能な顕微タイプ | ||
● TSVウェハー厚検査装置 SM-3000M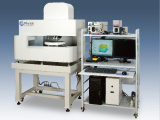 顕微光学系の採用によりTSVビア裏面のSi厚測定やボンディング層の測定が可能です。
|
| ウェハー基板の研磨プロセス中の厚みをリアルタイムに計測 | ||
● 分光干渉式ウェハー厚み計 SF-3 高速・リアルタイムで研磨モニタが可能です。長いワークディスタンスに対応実現し、機器への組み込みが容易に可能です。高速Rθステージを付けることで、61ポイント60秒で測定可能です。
|
キーワード:450mmウェハー厚測定、多層厚み、仮貼り合せウェハー、5μm~2mm厚測定、TSVウエハー、TTV,分光干渉式、Si、 SiC、 SOI、
ボンディング、デボンディング、300mm、CMP、BG、ウェットエッチング、BSI
ボンディング、デボンディング、300mm、CMP、BG、ウェットエッチング、BSI